在半導體技術加速迭代升級的時代浪潮中,芯片集成度持續攀升、晶圓尺寸向大規格演進、材料體系呈現多元化的蓬勃態勢。在此行業背景下,不同的劃裂解決方案能為半導體多元化制造提供更多的可能性,在半導體產業鏈中占據不可或缺的關鍵地位。
大族半導體依托深厚的技術積淀與前瞻的市場洞察,重磅推出全新一代DC-CP8060全自動化合物芯片解理劃裂線設備(以下簡稱“DC-CP8060線體機”)。該設備歷 經嚴苛的技術驗證,精準契合了半導體制程中紛繁復雜的需求,為行業發展注入了源源不斷的革新動力。

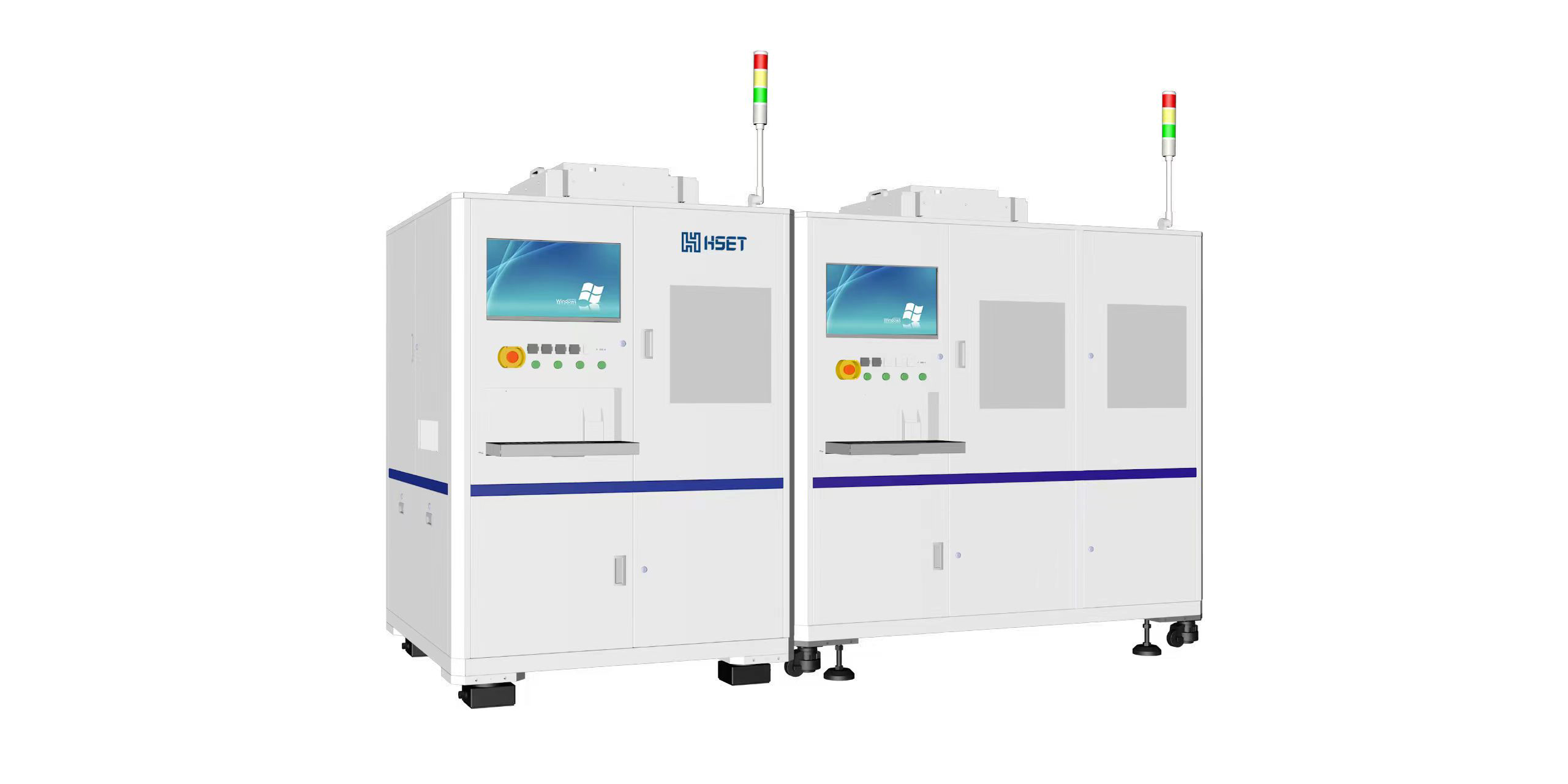
機型:DC-CP8060


DC-CP8060 線體機在芯片領域應用廣泛,主要覆蓋光學器件、激光器芯片、光通信芯片等多個前沿領域,常見適配材料種類:GaAs、InP、GaN、SiC等。


DC-CP8060線體機采用“全自動金剛石劃線 + 全自動貼膜PET+全自動裂片” 全流程工藝(劃深<3μm,劃寬 3-5μm),以集成化設計實現效能躍升,該設備有以下顯著優勢:
高潔凈度環境保障
1.新增FFU潔凈系統,實現高潔凈度環境作業;
2.生產全程無需水洗作業;
3.采用干式冷加工工藝,有效規避產品加工面熱影響。
產品高利用率
產品切割道最小可精準控制在12μm。
產品多樣性兼容
支持全自動激光器芯片、光通信芯片處理流程(晶圓-CELL-Bar-Chip),充分兼容不同規格和類型的產品。
多材質兼容
兼容GaAs、InP、GaN、SiC等多種半導體材料。
功能一體化集成
綜合切割、貼PET膜、裂片等功能于一體,實現全自動化一體化生產。


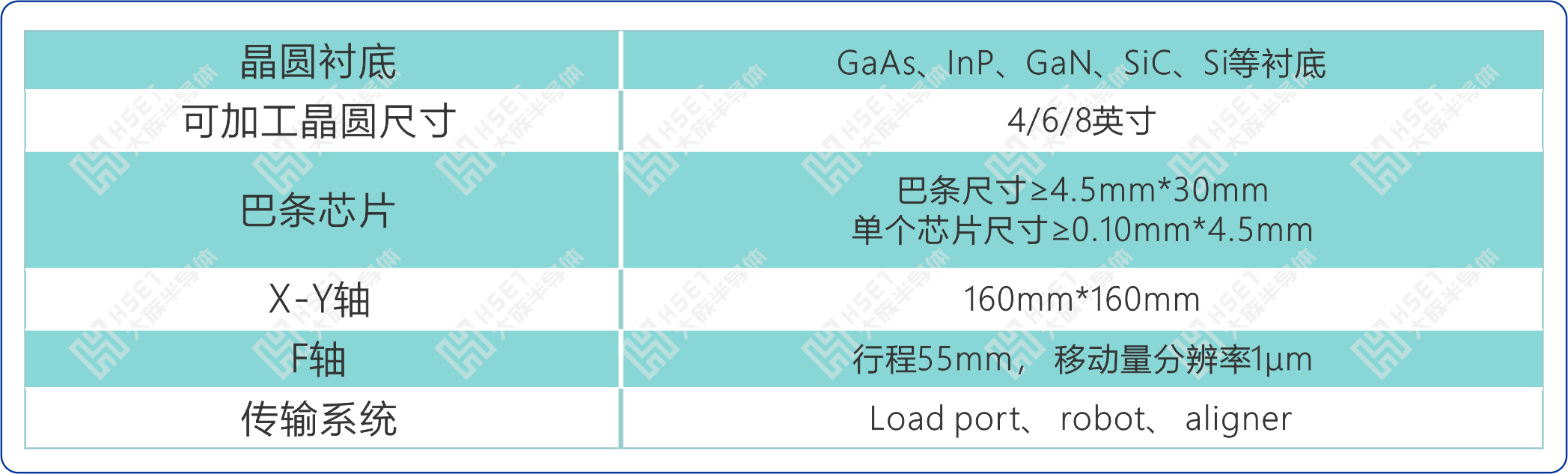


金剛石劃線加工原理
大族半導體劃裂設備可根據產品材質及加工工藝需求,精確匹配劃線刀、劃刀角度和劃刀克重,通過金剛石劃刀在產品表面形成微小V槽(深度<3μm),該工藝可根據晶圓厚度精確控制劃線深度,確保晶粒的分離效果。

裂片加工原理
采用三點折彎原理,通過標準流程實現精準裂片,保障晶粒切割的一致性,具體步驟如下:
定位校準
高精度視覺系統實時校準劈裂位置,達到微米級定位精度。
力學斷裂
產品放置于可調間距的支撐臺上,裂刀(刀刃刃寬 5-10μm)快速下壓,使晶圓沿劃痕精準斷裂,形成尺寸統一的晶粒。






大族半導體 DC-CP8060 全自動化合物芯片解理劃裂線設備,以廣泛的應用領域、顯著的設備優勢和科學的劃裂原理,已成為半導體產業高速發展進程中的又一革新設備。展望未來,大族半導體將堅定不移地以創新為核心驅動力,持續賦能行業變革。依托前瞻性的技術布局,不斷優化升級產品矩陣,引領半導體制造產業向更高品質、更優效能的方向邁進。

